掩膜的“大”麻烦
热搜大全 2024-03-12

作者 | 杜芹
近日,一段 ASML 的高数值孔径(High-NA) EUV 光刻机进驻英特尔工厂的视频,引发了半导体行业的广泛关注。因为,这关乎着摩尔定律能否继续走下去。对于 2nm 以下的芯片制造,拥有更高数值孔径的 0.55 High-NA EUV 光刻机起到至关重要的作用。
然而,一个不争的事实是,High-NA EUV 光刻机要比上一代 EUV 光刻机要复杂的多,其必然带来芯片设计和制造的新挑战。作为最早购买到 High-NA EUV 光刻机的英特尔,近日其 CEO 帕特 · 基辛格在 More than moore 的一次采访中透露,想采用更大的掩膜来发挥 High-NA EUV 光刻机更大的经济效益。
一台 EUV 光刻机的成本约为 2.5 亿美元,而这台高数值孔径(High-NA)EUV 光刻机的成本大约为 4 亿美元。如此昂贵的投资,值得吗?我们都知道,摩尔定律本质上属于经济定律。摩尔定律指出,集成电路上的晶体管数量每隔 18 个月会翻一番,而芯片的成本会下降一半。这推动了芯片制造技术的不断进步,也使得电子产品变得更加普及。
不由发问,芯片微缩(or 摩尔定律)的下一步,是制造更大的掩膜吗?
原因几何?
众所周知,在当下先进工艺芯片制造过程中,光刻是芯片制造中最关键的工艺步骤之一,其精度直接影响芯片的良率和性能。为了继续缩小逻辑和存储节点,光刻工具必须能够打印更小的特征。通过增加数值孔径,High-NA EUV 光刻机能够实现更小的特征尺寸和更高的图案密度,可以说是 " 全村的希望 "。
虽然 High-NA EUV 光刻机带来了更高的分辨率等好处,但是其也带来了其他的不利之处。与普通的 EUV 光刻机相比,High-NA EUV 光刻机最大的变化是,其曝光视场减半(即在单个曝光步骤中曝光的晶圆区域较小了一半)。
High-NA EUV 使用变形镜头,X 和 Y 方向的放大倍率存在差异,其掩模尺寸的缩小比例在水平方向不变,保持 4 倍,但在垂直方向上缩小了 8 倍,这导致曝光区域缩小了一半,变成了 26 x 16.5 毫米,目前业界标准的 EUV 曝光区域是 26 x 33 毫米。这意味着,High-NA EUV 光刻机掩模能够映射到晶圆上的区域面积减少了一半,形成了所谓的半场成像。因此,对单个晶圆进行图案化需要两倍的曝光次数,这也使得打印晶圆的时间延长了一倍。
一个解决方案是,将设计分成两个掩模版并缝合在一起,但这不是易事。想象一下,尝试用两张相邻的底片打印一张照片来生成一张无缝的图片,这是非常困难的。
而且,如今为了满足 AI、5G 等计算能力需求旺盛的应用程序的需求,行业正在朝着大芯片的方向发展,许多当前的 Nvidia 芯片无法使用 High-NA EUV 进行打印。这个挑战将早早晚晚不得不解决。
因此,业界开始考虑另外一种方案:生产更大的掩膜。掩膜(Mask)是光刻过程中的关键元素。掩膜上有预先定义的图案,这些图案在光刻过程中通过曝光光线传递到晶圆上,形成电路图案。掩膜的精确度和尺寸直接关联到最终产品的质量和产量效率。
作为最早 " 吃螃蟹 " 的英特尔,正在带头推动半导体行业采用更大的掩模尺寸标准。虽然英特尔表示,与传统的双重曝光技术相比,High-NA EUV 光刻机的单次曝光技术可以减少工艺步骤,提高生产效率,降低生产成本。而且,相比其他多图案和自对准技术,High-NA EUV 光刻也具有优势。
但帕特 · 基辛格也指出,也许更大的掩模尺寸可以使 EUV 整体上更加经济。
目前 EUV 光刻机所使用的标准掩膜尺寸是 6 x 6 英寸。英特尔希望 ASML 和英特尔内部的掩模制造团队,能够研发更大尺寸的掩模,将掩模尺寸加倍到 6 x 12 英寸,恢复到标准的曝光区域大小。这样就可以在生产较大芯片时避免复杂且难度较高的缝合过程。
综合来说,使用更大的掩模尺寸可以带来以下优势:
提高产量:在一个步骤中曝光更多的晶圆面积可以提高产量。
降低成本:减少曝光步骤可以降低成本。
消除设计限制:更大的掩模尺寸可以使芯片制造商在设计芯片时更加灵活。
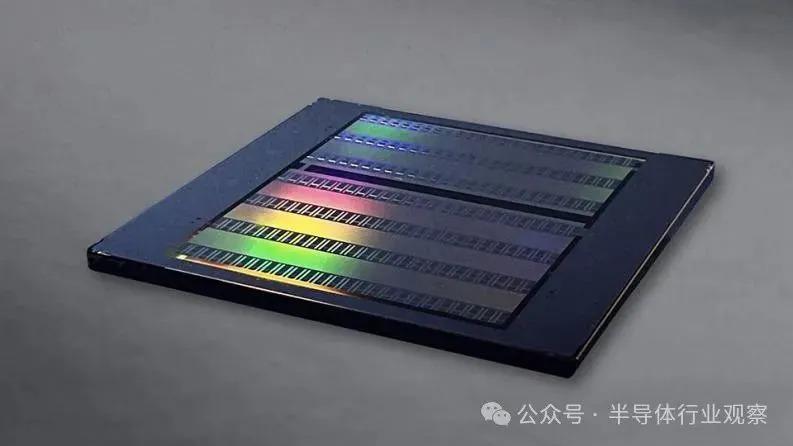
EUV 光掩模(图源:Toppan Photomask)
据悉,英特尔获得的 High-NA EUV 光刻设备最初将用于学习和掌握该技术,并计划在未来两到三年内在英特尔 18A 工艺节点上实现(尽管不是用于大批量生产),并最终采用其英特尔 14A 制造工艺进行大批量制造。

英特尔 4 年 5 个节点
挑战重重
然而,掩膜尺寸的扩大是一项巨大的技术挑战,而且还会产生许多连锁反应,因为当前的掩模基础设施是围绕 6x6 英寸方形掩模版基础设施设计的。将掩膜尺寸扩大到 6x12 可能需要新的光刻胶、计量、薄膜材料、掩模和检查工具等,不可避免的要对基础设施重新进行大量投资。即使在当前尺寸下,生产无缺陷掩模坯料也是低数值孔径 EUV 开发的一个障碍,更不用说扩大一倍。
从本质上讲,整个掩模行业的供应链都必须改变,可谓是牵一发而动全身。相关的产业链主要有:
掩膜版写入器:IMS Nanofabrication GmbH 是一家销售 6 x 6 英寸掩模的掩模写入器的公司。英特尔和台积电都是它的股东。IMS 很大程度上可能将支持 6 x 12 英寸格式。生产 EUV 掩膜写入器的重要厂商还有应用材料。
光掩膜版:通常掩膜版是由涂有金属膜和感光剂的 6 x 6 英寸玻璃基板制成,制作 6 x 12 英寸的掩膜版比标准 6 x 6 英寸的掩膜版要复杂,因为它需要更大的玻璃基板和更多的材料。同时,制造过程中对精度和均匀性的要求更高,因为任何小的缺陷在大尺寸掩膜上都可能放大。此外,处理和对齐更大的掩膜也会更加挑战,需要特殊的设备和技术。
2024 年 2 月,IBM 与日本光掩膜供应商 Toppan Photomask 签订了半导体 EUV 光掩模联合研发协议,从 2024 年第一季度开始的五年内,两家将合作开发用于 2nm 工艺节点的极紫外 ( EUV ) 掩模,还包括开发用于 1nm 技术的 High-NA EUV 技术的掩模。
掩膜保护膜:这是一种薄膜(pellicles),在芯片制造过程中覆盖在光掩模上。其主要作用是保护光掩模免受灰尘、碎屑和其他污染物的损坏。这些污染物会造成光掩模缺陷,进而导致芯片良率下降。与光掩膜类似,6x12 的薄膜开发相比 6x6 薄膜也会更具挑战性。
掩模检测设备:Lasertec 和 KLA 销售 EUV 掩模检测系统。Lasertec 于 2019 年发布了光化图案掩模检测 ( APMI ) 系统 ACTIS,此后一直将其作为 EUV 掩模检测的光化检测解决方案提供。Lasertec 已经在进行下一代 High-NA EUV 光刻检测设备的研究,预计可能会支持 6 x 12 英寸掩模(感兴趣的可以查看《Actinic pattern mask inspection for high-NA EUV lithography》)。
作为光刻机的制造商,ASML 需要适应更大尺寸掩模的变化。这是一项具有挑战性的任务,因为它涉及到多方面的技术和工程调整。
High-NA EUV 时代下,各产业链之间的复杂性和相互依赖性达到了新的水平。正如 EUV 需要生态系统整合一样,将 High-NA EUV 光刻技术投入生产也需要深入的协作和伙伴关系。学习如何利用它将推动下一个十年的半导体创新。
在这方面,美国纽约州与 IBM、美光和其他行业参与者投资了 100 亿美元扩建奥尔巴尼纳米技术园区,新建一个尖端的 High-NA EUV 中心,今年破土动工。其中包括在奥尔巴尼纳米技术综合体建造一个名为 NanoFab Reflection 的新设施,并购买 ASML 的 5200 High-NA EUV 设备。现有的 NanoTech Complex 成员,包括东京电子和应用材料公司,将与日本 Rapidus 等国际合作伙伴一起获得新的 EUV 设备的使用权。
大芯片?小芯片?
未来芯片设计之思考
从芯片设计公司的角度来看,如果要使用 High-NA EUV 光刻机生产更大的芯片,行业可能面临需要重新设计芯片以适应新技术的挑战。有几个趋势值得关注:
向 Chiplet 迈进:由于制造大尺寸的芯片在成本和复杂性上都较高,制造商可能会重新评估单个大芯片的设计。通过优化设计,可以将大芯片分割成多个小芯片,每个小芯片执行特定的功能。这些小芯片可以在后期通过封装技术整合,实现与单个大芯片相同或更好的性能。这不仅能减少生产难度,还可以提高产出的灵活性和整体性能。
先进芯片封装技术的发展:随着芯片尺寸减小,先进的封装技术变得至关重要,因为它们允许不同的芯片组件在较小的空间内集成,而不会牺牲性能。通过多芯片模块(MCM)或芯片堆叠技术等封装方法,可以实现高性能计算和存储,同时优化功率效率和信号传输。这些技术的进步是克服 High-NA EUV 在制造大型芯片方面遇到的挑战的关键。
写在最后
总结来说,在经济定律为本之下,High-NA EUV 还有很长的路要走。
相信这也是台积电谨慎选择 High-NA EUV 光刻机的个中原因。有分析师表示,High-NA EUV 可能要到 2030 年或更远的时间才会出现在台积电的路线图上。
High-NA EUV 光刻机其他潜在厂商还包括三星、美光、SK 海力士。ASML 已经透露了大约 10~20 个 High-NA EUV 设备订单。ASML 韩国公司总裁 Lee Woo-kyung 在参加今年 1 月举行的 SEMICON 韩国 2024 行业领导晚宴之前透露," 我们期待 2027 年带来三星电子和 ASML 的合资企业新研发中心的 High-NA EUV 设备。" 据悉,三星电子从 1nm 工艺开始就使用该设备。其他厂商暂无明确信息透露。
对于 High-NA EUV 光刻机的实际商用,未来台积电和三星又会如何看待增大掩膜尺寸的问题呢?